[인더뉴스 정재혁 기자] 주택담보대출에 대한 채무조정 제도가 개선된다. 신용회복위원회를 통한 주담대 채무조정과 법원 개인회생 채무조정(신용대출)의 병행 이용이 가능해지고, 은행 등 채권자의 부담을 완화하기 위해 주담대 부실채권의 정상채권 재분류 소요시간이 단축된다.
금융위원회(위원장 최종구)와 신복위(위원장 이계문)는 채무상환에 어려움을 겪는 주담대 채무자들이 주택상실 우려 없이 안정적으로 채무를 상환할 수 있도록 서울회생법원(법원장 이경춘)과 연계해 ‘주택담보대출 채무조정 활성화 방안’을 마련했다고 17일 밝혔다.
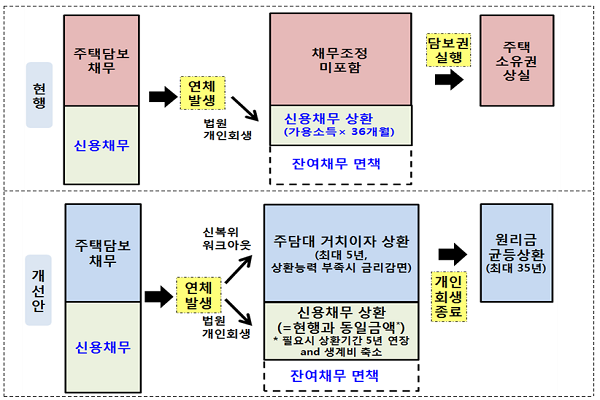
기존 법원 개인회생의 경우 채무조정 대상에 신용대출만 포함되며 담보대출은 담보처분을 통해 대출을 갚도록 제외했다. 따라서 개인회생 중 채권자(은행 등)가 주택을 경매할 경우 채무자는 주거를 상실하며, 이로 인한 주거비 부담으로 개인회생 이행에도 차질이 발생하는 문제가 있었다.
또한, 신복위의 채무조정은 주담대도 포함해 조정하고 있지만, 경매나 주담대 매각 등에 비해 채권자의 참여유인이 낮아 실적이 저조한 것으로 나타났다. 채무조정안에 따라 주담대를 상환 받을 경우 오랜 기간 대손충당금을 적립하고, 부실채권 비율도 높아지기 때문이다.
아울러, 신복위를 통한 주담대 채무조정과 법원 개인회생을 통한 신용대출 채무조정은 함께 병행하는 것이 사실상 불가능하다. 신복위 채무조정은 개인회생을 신청한 경우 이용할 수 없다.
이러한 현실을 감안해 정부는 채무자가 신복위의 채무조정과 법원의 개인회생 신용대출 채무조정을 동시에 병행 이용할 수 있도록 하는 ‘개인회생 연계형 신복위 주담대 채무조정 프로그램’을 신규 도입한다.
희망자는 우선 법원에 주담대 연계 개인회생을 신청하고, 이후 법원 요청에 따라 신복위는 채무조정안을 마련한다. 법원은 이 조정안을 고려해 최종 변제계획을 인가하게 된다.
단, 신청 대상은 생계형 주택 실거주자(주택가격 6억원 이하, 부부합산 연소득 7000만원 이하, 실거주주택)만 가능하다. 주담대의 경우에는 연체 발생 후 30일이 경과해야 신청할 수 있다.
예를 들어, 월소득 300만원, 주담대 2억 2000만원, 신용대출 1억원을 보유한 2인 가구가 법원에 주담대연계 개인회생을 신청할 경우, 우선 신복위는 5년 간 거치기간을 부여하고 거치기간 중 매월 73만원(2억 2000만원x4%/12개월)씩 거치이자를 상환하는 주담대 채무조정안을 마련한다.
법원은 생계비와 주담대 거치기간 이자를 제외한 채무자의 잔여소득으로 신용채권자가 일반 개인회생과 동일한 4680만원(78만원x60개월)을 상환받을 수 있도록 상환기간 연장(3년→5년), 생계비 축소(170만→149만원)해 회생안을 마련한다.
신복위 채무조정 주담대에 대한 자산건전성 분류도 개선돼, 주담대에 대해서는 신복위 채무조정 후 1년 간 성실상환(거치기간 포함)하면 정상채권으로 재분류할 수 있도록 건전성 기준을 개정한다. 현행 정상채권 재분류 소요시간은 최소 3년 6개월에서 최대 10년에 달한다.
금융위 관계자는 “담보권 실행 때 원본회수(대손준비금 해소) 기간과 유사하게 조정함으로써 채무조정 수용에 따른 채권자의 불이익을 완화했다”며 “단, 채무조정안 이행 중 연체가 재발생하면 현행 기준대로 엄격 관리할 예정”이라고 말했다.
‘개인회생 연계형 신복위 주담대 채무조정 프로그램’은 17일부터 서울회생법원 관할 개인회생 사건에 대해 우선 도입된다. 금융당국은 향후 적용지역 확대를 법원과 협의할 예정이다.
신복위 채무조정 주담대에 대한 자산건전성 분류기준 개선은 오는 2분기 중 은행업 감독규정과 보험·여전·저축은행 등 행정지도 개정을 통해 적용될 것으로 보인다.



![[인더필드] 더미식 신제품 ‘사천자장면’…하림은 확실한 2위 노린다](https://www.inthenews.co.kr/data/cache/public/photos/20240416/art_17134232137832_86acb8_120x90.jpg)















