
인더뉴스 권지영 기자ㅣ삼성전자가 중국의 대형 인터넷 검색엔진 기업 바이두(Baidu)의 14나노 공정 기반 AI 칩 ‘쿤룬(KUNLUN)’을 내년 초에 양산할 계획입니다.
삼성전자와 바이두의 첫 파운드리 협력으로 삼성전자는 클라우드, 엣지컴퓨팅 등에 활용될 수 있는 AI 칩까지 파운드리 사업의 영역을 확대해 나가고 있는데요.
특히 양사는 이번 제품의 개발부터 생산까지 긴밀하게 협조했습니다.
바이두의 ‘KUNLUN(818-300, 818-100)’은 클라우드부터 엣지컴퓨팅까지 다양한 분야의 AI에 활용될 수 있는 인공지능 칩입니다. 바이두의 자체 아키텍처 ‘XPU’와 삼성전자의 14나노 공정, I-Cube(Interposer-Cube) 패키징 기술을 적용해 고성능을 구현한 제품입니다.
삼성전자는 HPC(High Performance Computing)에 최적화된 파운드리 솔루션을 적용해 기존 솔루션 대비 전력(PI, Power Integrity)과 전기 신호(SI, Signal Integrity) 품질을 50% 이상 향상시켰습니다.
이는 칩에 신호가 전달될 때 발생하는 노이즈를 개선해 전압을 일정하게 유지해 회로가 보다 안정적으로 구동될 수 있도록 했다는 뜻입니다.
I-Cube(Interposer-Cube)는 SoC 칩과 HBM(고대역폭 메모리) 칩을 실리콘 인터포저(Si-Interposer) 위에 집적하는 삼성전자의 차별화된 2.5D 패키징 기술입니다. 이 기술은 각각의 칩을 1개의 패키지 안에 배치해 전송 속도는 높이고 패키지 면적은 줄일 수 있는 점이 특징입니다.
바이두의 AI 반도체 개발을 총괄하는 오양지엔(OuYang Jian) 수석 아키텍트는 "KUNLUN의 성공적인 개발로 HPC 업계를 선도하게 돼 기쁘다"라며, "KUNLUN은 높은 성능과 신뢰성을 목표로 하는 매우 도전적인 프로젝트였으며, 삼성의 HPC용 파운드리 솔루션을 통해 우리가 원하는 결과를 얻을 수 있었다"라고 말했습니다.
삼성전자 DS부문 파운드리사업부 마케팅팀 이상현 상무는 “모바일 제품을 시작으로 이번에 HPC 분야까지 파운드리 영역을 확대하게 됐다”며 “향후에도 에코시스템을 통한 설계 지원, 5/4나노 미세 공정과 차세대 패키징 기술 등 종합 파운드리 솔루션을 제공할 것”이라고 말했습니다.
삼성전자는 앞으로도 다양한 응용처에서 전략적 파운드리 협력을 지속적으로 확대해 나간다는 전략입니다.
☞ 용어 설명
· 2.5D 패키징 기술- 인터포저(Interposer)를 이용해 SoC(CPU, GPU 등)와 메모리 칩(HBM 등)을 모두 1개의 패키지 안에 배치해 성능은 높이고, 패키지 면적은 줄이는 기술.
· 인터포저(Interposer)- IC 칩과 PCB(인쇄회로 기판) 상호 간의 회로 폭 차이를 완충시키는 역할을 함. 미세 공정으로 제작된 IC 칩의 입출력 패드 간격과 PCB의 입출력 패드 간격이 다를 때 IC 칩과 PCB 사이에 추가적으로 삽입하는 미세회로 기판을 의미함. 일반적으로 IC 칩의 입출력을 재분배하기 위해 다층 배선 구조로 구성됨.
· HBM(고대역폭 메모리, High Bandwidth Memory)- 고대역폭 메모리 규격으로, 국제 반도체 표준화기구인 JEDEC에서 2013년 산업 표준으로 채택했음. 데이터를 읽고 쓰는 속도에 따라 세대별로 HBM, HBM2, HBM3 등으로 구분됨.
· HPC(High Performance Computing)- 슈퍼컴퓨터 또는 빅데이터 전용 클라우드 서비스 등을 제공하는 초고성능 컴퓨팅 시스템.


![[C-레벨 터치]치킨 3위 교촌…허니시리즈 만든 송종화 ‘절박함’ 통할까](https://www.inthenews.co.kr/data/cache/public/photos/20240417/art_17138369463842_6d6cce_357x250.png)
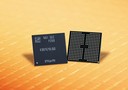

![[인더필드] 더미식 신제품 ‘사천자장면’…하림은 확실한 2위 노린다](https://www.inthenews.co.kr/data/cache/public/photos/20240416/art_17134232137832_86acb8_120x90.jpg)













